EUV光刻机,大结局?
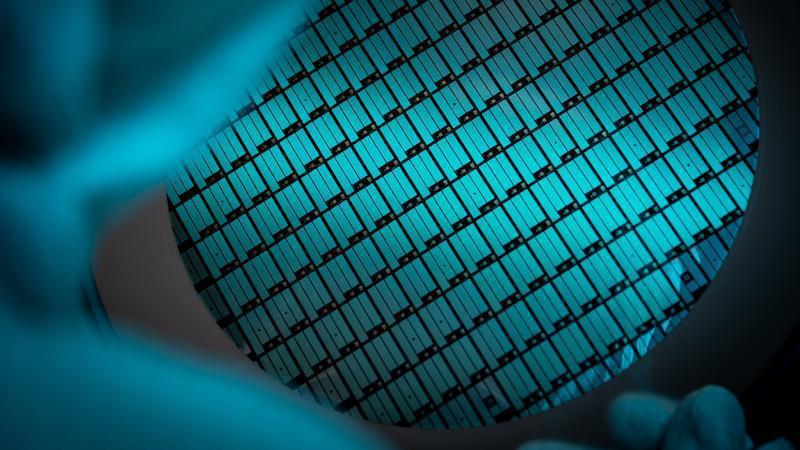
瑞利判据一直是光刻机发展的根本遵循,被光刻产业界奉为 " 金科玉律 "。同时,公开发表的 " 突破瑞利判据 " 的理论与实验学术论文数以万计,成就了诸多的 " 全球高被引科学家 "。那么,瑞利判据的尽头,BEUV(Beyond Extreme Ultraviolet,超越极紫外)光刻机是否会演化成光刻机的大结局?BEUV 光刻机的商业化进程又面临哪些挑战?
一、前言
芯片号称现代社会的 " 工业粮食 ",是信息产业的基石。自 1958 年集成电路诞生之日以来,芯片产业日益成为国民经济和社会发展的战略性、基础性、先导性产业。
芯片深刻地改变了人类的生产生活方式,从手机、家电、汽车等以大众消费者为导向的 C 端产品,到医疗设备、电力、交通运输、电信、电子政务等以业务为导向的 B 端产品,再到国防领域中的卫星、导弹、航母等装备,都离不开小小的芯片。所谓的 " 三百六十行,行行用芯。"
一颗芯片的诞生流程极其漫长,经历重重考验,可分为芯片设计、前道工序(芯片制造)和后道工序(封测)三个环节。
前道工序是芯片产业链的核心环节,是指根据芯片设计版图,采用乐高盖房子方式,以晶圆作为地基,在晶片或介质基片上进行扩散、薄膜、光刻、刻蚀、离子注入、化学机械抛光(CMP)、金属化、量测等工序,层层往上叠的芯片制造流程,最终将芯片设计公司设计好的电路图移植到晶圆上,并实现预定的芯片电学功能。
前道工序九大设备主要包括:扩散炉、薄膜沉积设备(包括 PECVD、LPCVD、ALD 等)、光刻机、涂胶显影机、刻蚀机、离子注入设备、CMP、量测设备和清洗设备。
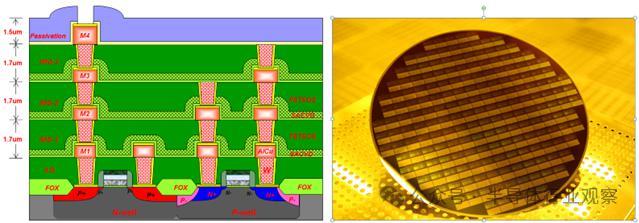
芯片的内部结构(左)及晶圆(右)。
在芯片制造流程中,光刻技术水平直接决定了芯片的最小线宽,定义了半导体器件的特征尺寸,直接决定芯片的制程水平和性能水平。毫无疑问,光刻工艺是芯片制造流程中技术难度最大、成本最高、周期最长的环节。先进技术节点的芯片制造需要 60-90 步光刻工艺,光刻成本占比约为 30%,耗费时间占比约为 40%~50%。
光刻机则是前道工序九大设备之首,在芯片生产线总投资的占比约为 20%。光刻机集成了物理学、超精密光学、精密仪器、高分子物理与化学、数学、材料、自动控制、流体力学、高精度环境控制、软件等 40 多个学科的最新科学成就,在 60 余年的发展历程中, 光刻机(包括其零部件)不断挑战人类超精密制造装备的极限,被誉为 " 现代光学工业之花 ",芯片产业 " 皇冠上的明珠 "。
瑞利判据一直是光刻机发展的根本,被光刻产业界奉为 " 金科玉律 "。当前的光刻机发展已经进入高 NA(Numerical aperture,数值孔径)的 EUV 光刻时代,制程可达 2nm 及以下,预计 2025 年开始量产。
那么,后 NA EUV 光刻机将如何演化?BEUV(Beyond Extreme Ultraviolet,超越极紫外)光刻机是否会演化成光刻机的大结局?
二、瑞利判据的诞生
要回答这些问题,首先不得不回顾一下瑞利判据的前世。
这不得不提到三位杰出的科学家:英国皇家天文学家乔治 · 比德尔 · 艾里(George Biddell Airy,1801 年 ~1892 年)、德国物理学家恩斯特 · 阿贝(Ernst Abbe,1840 年 ~1905 年)和英国物理学家瑞利(J.Rayleigh,1842 年 ~1919 年)。
1835 年,乔治 · 比德尔 · 艾里在一篇 "On the Diffraction of an Object-glass with Circular Aperture" 的论文中对圆孔衍射进行了理论解释,第一次明确给出衍射极限概念。
基于光的衍射特性,一个无限小的理想光点,通过任何尺寸的 " 完美 " 镜头(实际上每个镜头都具有限定的孔径, 都具有像差)成像后,也会形成一个弥散的图案,即一个明暗相间的圆形光斑。其中以第一暗环为界限的中央亮斑称作 "Airy 斑 "。简而言之,Airy 斑中心是一块明亮区域,周围是一系列亮度不断降低的同心圆环。

无限小的发光点通过透镜成像系统后,形成 "Airy 斑 "
1863 年,恩斯特 · 卡尔 · 阿贝成为耶拿大学一名讲师(Privatdozent)。1866 年,蔡司(Carl Zeiss, 1816 年 ~1888 年)聘请当时年仅 26 岁的阿贝作为独立研究员,从事光学显微镜的设计和研究。需要指出的是,阿贝的物理讲座也需要蔡司公司制造的光学仪器。1872 年,阿贝辞去了耶拿大学的工作,正式加盟蔡司公司。
1873 年,阿贝基于 "Airy 斑 " 原理,提出了 "Abbe 光学衍射极限理论 "(Diffraction limitation),分辨率定义为:

其中,λ 是光波长,n 是样品与显微物镜之间介质的折射率,是显微物镜的孔径角。
阿贝是首位定义数值孔径术语的科学家。具体来说,NA=nsin, 是透镜成像系统的数值孔径。因此,分辨率也可被定义为 :

简而言之,传统光学显微镜能够探测到的物体最小细节是光波长的一半。该经典的公式被刻于阿贝墓碑上。
1884 年,阿贝和奥托 · 肖特(Friedrich Otto Schott,1851 年 ~1935 年)在耶拿创建肖特玻璃厂。
众所周知,当前,EUV 光刻机的镜头系统由蔡司公司所制造,镜头系统采用的超低热膨胀玻璃来自于肖特公司。
1896 年,英国物理学家瑞利以 "Airy 斑 " 理论为基础,对 "Abbe 光学衍射极限理论 " 进行了进一步的延伸和细化,建立了 " 瑞利判据 "(Rayleigh Criterion)。如果一个点光源的衍射图像的中央最亮处刚好与另一个点光源的衍射图像第一个最暗处相重合,瑞利认为这两个点光源恰好能被这一光学仪器所分辨。

瑞利判据示意图
" 瑞利判据 " 是第一个明确给出了光学仪器分辨本领的准则。在此准则下,光学仪器的分辨率为:

瑞利判据通常使用在光学成像的领域,包括显微镜、望远镜、摄影和其他光学成像设备,用于目前各类光学仪器的最高空间分辨率的计算公式。瑞利判据为我们提供了一个判断物体细节是否可以被光学显微镜分辨的标准,同时也指导我们如何提高显微镜的分辨率,例如通过选择更短的辐射波长、提高折射率或使用具有更大半孔径角的显微镜等方法。
瑞利的研究工作涵盖了电学、声学和光学等多个领域。1904 年,诺贝尔物理学奖授予瑞利,以表彰他在研究最重要的一些气体的密度以及在这些研究中发现了氩。
光刻机的瑞利判据公式如下:

其中,CD 是光刻图形的特征尺寸,光学系统在晶圆上可实现的最小线宽,即光刻机的分辨率,k1 是工艺因子,DoF 是光刻焦深,k2 是工艺因子。
至此,瑞利判据是波长和数值孔径的表达式,它描述了光刻机衍射极限系统中的分辨率极限,成为了光刻机发展的基础,近 60 年来,一直被光刻产业界奉为 " 金科玉律 "。
三、瑞利判据下光学光刻机的演进
瑞利判据表明,物体上两点之间的距离大于某个特定值时才会被分辨。这个特定值与入射光的波长和数值孔径 NA 有关。在光刻过程中,分辨率的极限直接决定了光刻机能够制造的最小特征尺寸。
光刻机的设计师和工程师们必须根据瑞利判据来优化光刻机的设计与制造,以提高光刻分辨率极限,使光刻机能够区分的两个点之间的距离越来越小。根据瑞利判据,提高单次光刻分辨率的方法主要有以下三种途径:
1. 缩短曝光波长;
2. 增大投影光刻物镜的数值孔径 NA;
3. 减小光刻工艺因子。
除了分辨率之外,焦深 DoF 也是一个关键参数。在实际的光刻过程中,光刻机镜头会有一个焦点,而在这个焦点的周围存在一个晶片表面可以在垂直方向上移动的范围,只要光刻胶(即感光层)的厚度在这个范围内,那么整个胶层都能得到清晰的曝光,不会导致光刻分辨率出现显著的下降。
一般来说,光刻的分辨率越高,焦深越小。也就是说,光刻允许的工艺容差就越小。在实际操作过程中,晶片的表面位置有纳米尺度的变动,也会导致图案的细节部分变得模糊,对光刻结果产生显著的影响。这对光刻机的调平调焦系统提出了更为苛刻的要求。
第一种提高光刻分辨率途径,光刻机的波长已经经历了从 435nm(G- 线)、365nm(I- 线)、248nm(深紫外,DUV)、193nm(ArF,干式和水浸没式)到目前的 13.5nm(极紫外,EUV)的发展历程。
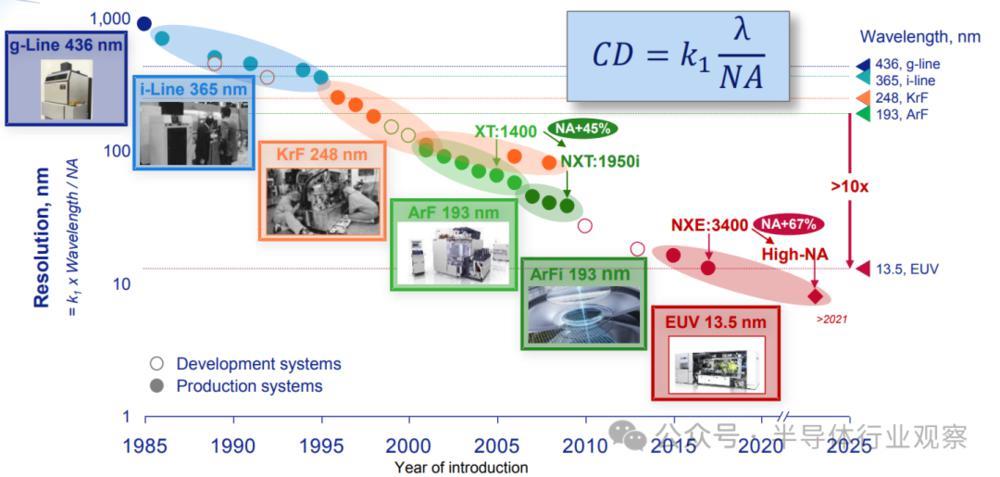
光学光刻机的演进
第二种提高光刻分辨率途径,数值孔径 NA 越大,收集的衍射束就越多,光刻分辨率就越高。DUV 光刻机投影透镜的数值孔径 NA 也从 0.4 增大到 0.93,在 193nm 浸没式光刻机中,由于晶圆和透镜之间填充了水,数值孔径 NA 可以高达 1.35。对于 EUV 光刻机,数值孔径 NA 则从 0.33 提高到了 0.55。
第三种提高光刻分辨率途径,光刻系统分辨率的提高还可以通过优化工艺参数来实现。例如,离轴照明、计算光刻和光刻胶工艺,等等,用于减小工艺因子 k1。单次光刻 k1 反映了光刻工艺中的实际情况,其理论极限是 0.25。
为了进一步缩小工艺因子 k1,多重曝光技术也被提出来。理论上,"193nm 水浸没式技术 " " 多重曝光 " 可以应用于 3nm 节点的芯片生产。但是实际上,当芯片进入 7 nm 节点,工艺复杂度直线上升,其工艺步骤是 EUV 光刻的 5 倍,光刻次数是 EUV 光刻的 3 倍,从而造成了难以解决的 "80% 的芯片良率 " 问题。而 80% 的芯片良率通常是芯片工厂实现盈利的标准。
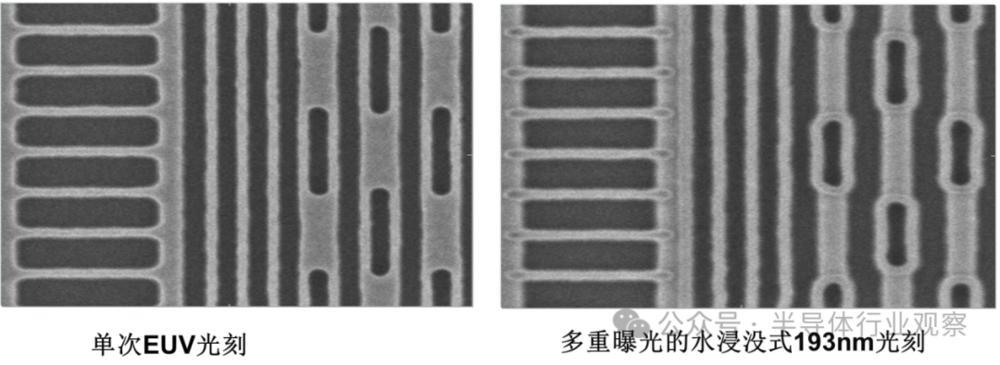
单次 EUV 光刻与多重曝光的水浸没式 193nm 光刻结果对比
2023 年前,ASML 最先进的 EUV 光刻机是 TWINSCAN NEX:3400C 和 TWINSCAN NEX:3400D,售价约为 1.7 亿欧元。其 NA 只有 0.33,对应的分辨率为 13nm,可以生产金属间距在 38nm~33nm 之间的芯片。
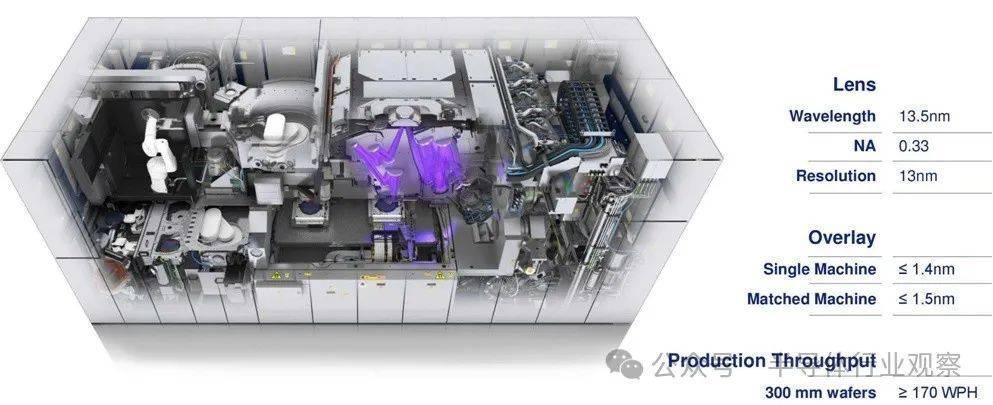
ASML 公司型号为 TWINSCAN NEX:3400D 的 EUV 光刻机
2023 年 12 月,ASML 研发的高 NA EUV 光刻机送达英特尔公司位于美国俄勒冈州的 D1X 工厂进行安装,该工厂已经成为英特尔公司最前沿研究的基地,也是该公司开发每一代芯片技术的地方。
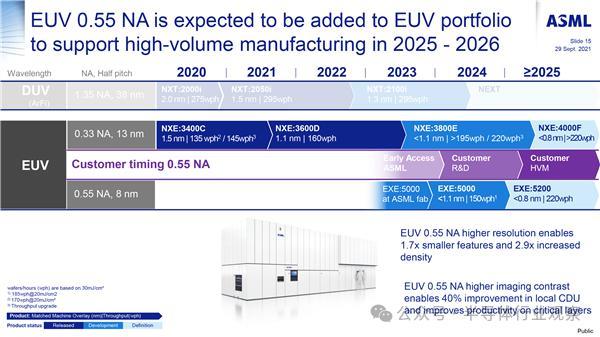
TWINSCA NEX: 5000 的高 NA EUV 光刻机即将进入芯片生产
2024 年 2 月 10 日, ASML 向媒体展示了该高 NA EUV 光刻机,型号为 TWINSCAN EXE:5000,NA 达到了 0.55,单次光刻分辨率达到了 8nm,售价高达 3.5 亿欧元(约合 27 亿元人民币)。英特尔公司已完成 Intel 18A(1.8nm)和 Intel 20A(2nm)制造工艺的开发。
上述芯片工艺或将有部分利用高 NA EUV 光刻机。除了英特尔公司以外,台积电、三星电子、SK 海力士、美光等头部晶圆厂商均在积极抢购或者有意向采购 ASML 新一代的高 NA EUV 光刻机。
四、瑞利判据的科学与实验突破
瑞利判据是一片笼罩在显微成像和光刻技术研究者头顶的阴霾。进入 21 世纪,多种超分辨成像技术打破了衍射极限的限制,突破了瑞利判据,带来了一场新的显微成像技术革命。
在显微成像领域里,典型的超衍射极限成像技术主要分为三大类:结构光照明显微成像技术(Structured illumination microscopy,SIM)、受激发射损耗显微成像技术(Stimulated emission depletion,STED)以及单分子定位显微成像技术(Single molecule localization microscopy,SMLM)。
其中最为有名的是 STED 成像技术。1994 年,德国马克斯普朗克生化研究所教授 Stefan W.Hell 在 Optics Letters 杂志上发表 STED 理论。鉴于此杰出工作,Stefan W.Hell 教授获得了 2014 年度的诺贝尔化学奖。
STED 成像技术源于爱因斯坦的受激辐射理论,是一种超分辨荧光成像技术。其基本原理可以理解成:既然衍射效应引起弥散斑,那就找块 " 橡皮 " 把弥散斑边缘擦除掉,这样就可以突破瑞利判据了。
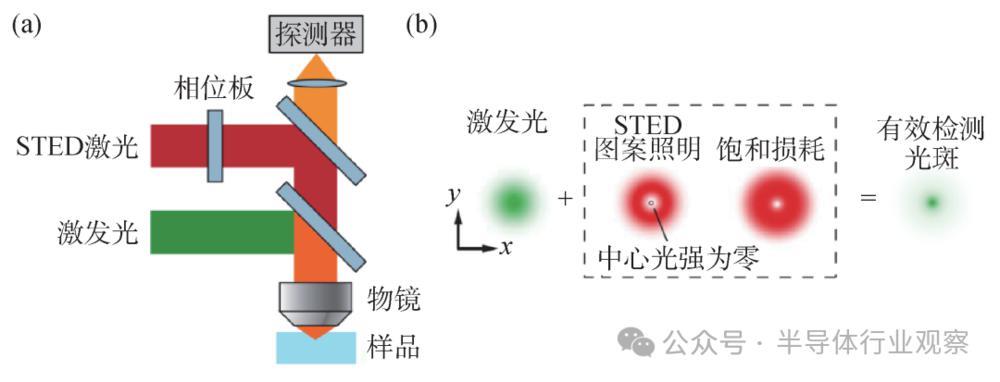
STED 技术原理图
超分辨成像的目的是将微小的物体放大,以供人类观察。但实际上,反过来的光刻过程(投影缩小)也是可行的。受 STED 成像技术的启发,2009 年,光刻技术研究者提出了基于单色边缘抑制的快速超分辨直写光刻技术。
一束 532nm 的飞秒激光用作" 铅笔光 ",形成实心光斑,实现光刻胶的双光子吸收激发聚合;另一束 532nm 的连续激光用作" 橡皮光 ",形成空心暗斑,实现单光子吸收抑制聚合。这两束光斑嵌套在一起,就能起到超分辨光刻的效果,目前已经可实现最小线宽 36nm 和最小分辨率 140nm 的超分辨刻写。

单色边缘抑制直写光刻系统
表面等离子体超分辨光刻通过调制表面等离子体透镜的物图形衍射的频谱分布,结合操控像平面处电场分量,实现倏逝波放大增强,将物体的像变成近场倏逝波的形式用于光刻。表面等离子体超分辨光刻理论上又不受到瑞利判据的限制。由于表面等离子体的等效波长可以达到 X 射线量级,可以在 i 线实现 22nm 以下的光刻效果,是传统衍射极限的 0.24 倍。
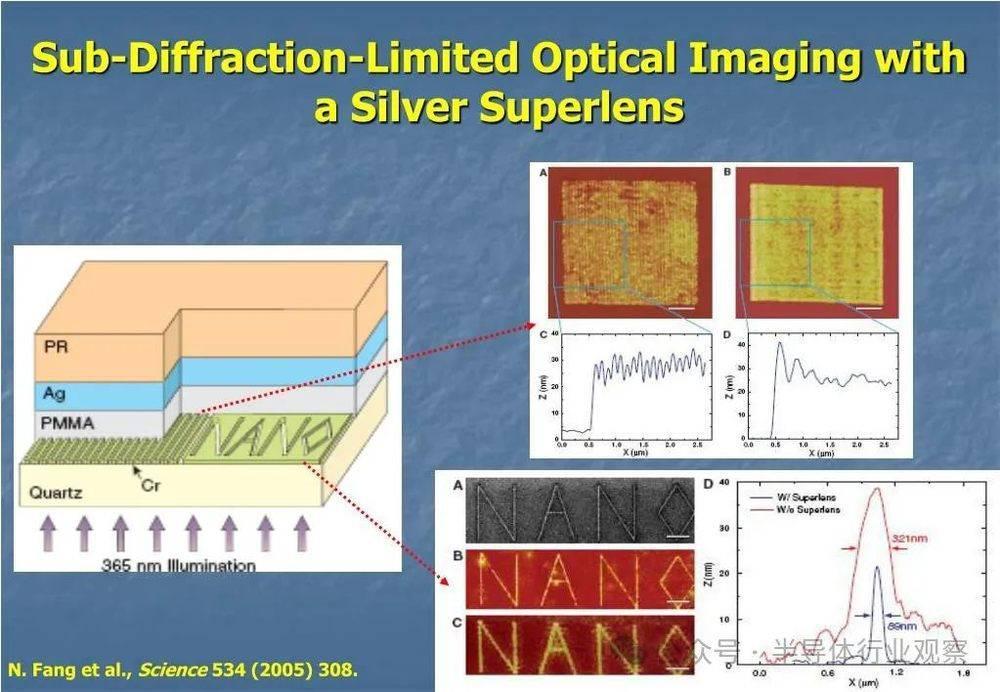
发表在 SCIENCE 杂志上的表面等离子体超分辨光研究结果
纳米压印光刻(Nanoimprint lithography,NIL)设备也是突破瑞利判据的重要途径。其原理非常简单,采用传统机械模具微复型原理,类似于印刷技术,将光刻胶涂在晶圆上,然后压上印有特定图案的印模,直接通过压印形成复杂的 2D 或 3D 图案。
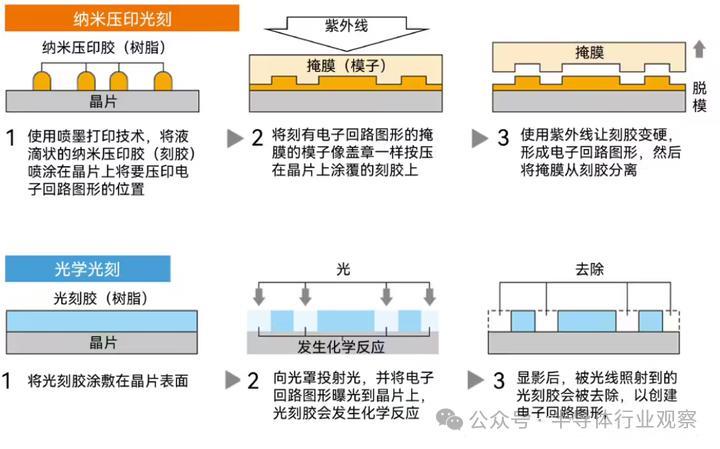
纳米压印光刻与传统光刻对比
2023 年 10 月 13 日,日本佳能公司宣布推出可以制造尖端芯片的纳米压印设备 FPA-1200NZ2C。日本佳能公司称该设备可实现最小线宽 14nm 的图案化,相当于 5nm 节点。随着掩模技术的进一步改进,NIL 有望实现 2nm 节点。该设备因为不使用镜头,所以光刻工艺成本 " 将比 ASML 的 EUV 少一位数 ",耗电量也会减少 90%。
普遍认为,NIL 技术被视为传统光刻技术的替代解决方案,在 3D NAND 集成电路领域可实现更低成本的芯片量产。
五、BEUV 光刻机技术的提出
国际设备和系统路线图 (IRDS)由产业界、政府和学术界共同制定。IRDS 仍保持国际半导体技术路线图(ITRS)的工作模式,每隔一年发布一个新的 15 年路线图,并每年更新。IRDS 是芯片产业发展的风向标。
IRDS 给出了 2037 年光刻技术的发展需求。尽管目前 ASML 最新型号的 Twinscan EXE:5000 的 EUV 光刻机勉强能满足需求。但是,由于多层反射器具有高反射率的角度范围有限,TWINSCAN EXE:5000 EUV 光刻机在扫描方向上的缩小倍率是 8:1,而在垂直方向上的缩小倍率维持在原来的 4:1。
这导致晶片上的最大曝光场尺寸为 26 毫米 ×16.5 毫米,原来的 NA 为 0.33 的 EUV 光刻机的最大曝光场尺寸为 26 毫米 ×33 毫米,这对制造大面积芯片以及 EUV 光刻机产率都有较大影响。

IRDS 对光刻技术发展的需求
IRDS 也给出了 2037 年光刻机的发展预测。从长远来看,一方面,有更高 NA(比如 NA 提高到 0.70)的 EUV 光刻机和波长为 6.X nm 的 BEUV(Beyond Extreme Ultraviolet,超越极紫外)光刻机两种选择。后者的可能性更大一些,主要原因是同等分辨率下,波长为 6.X nm 的 BEUV 光刻机比波长为 13.5nm 的 EUV 光刻机具有更大的焦深 DoF,带来更大的工艺容忍度。

IRDS 给出的光刻技术发展路线图
六、BEUV 光刻机技术面临的挑战
从长远来看,BEUV 光刻机的研发可以充分继承前期 EUV 光刻机的研发成果。但是也面临一些新的技术挑战,主要包括 6.X nm 光源、6.Xnm 多层膜和 6.Xnm 光刻胶。
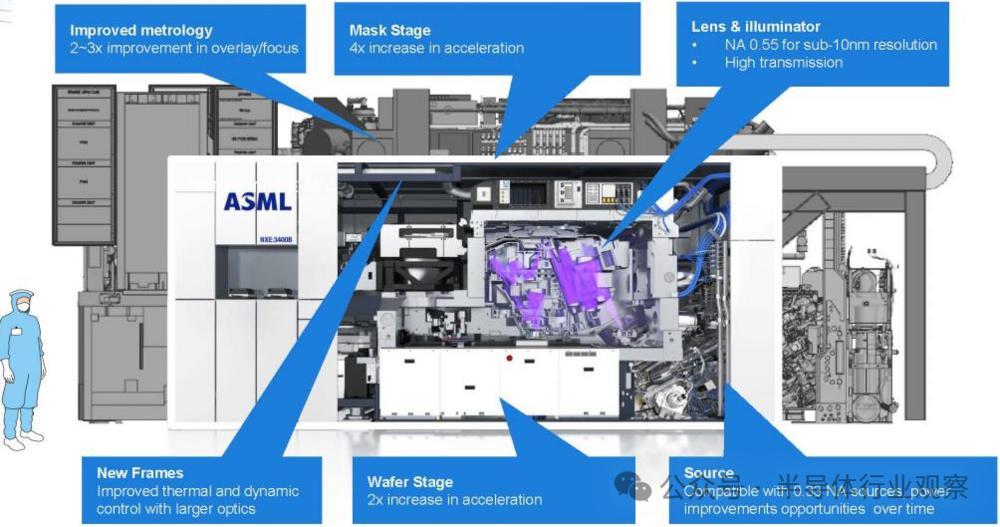
BEUV 光刻机充分继承前期 EUV 光刻机的研发成果
当前,产生 EUV 光源的方式有激光等离子体(laser produced plasma, LPP)、基于相对论电子束的各类加速器光源(包括同步辐射光源、自由电子激光器、稳态微聚束等)、放电等离子体(DPP) 和激光辅助放电等离子体(LDP)、高次谐波 EUV 光源等。
目前商用的 EUV 光刻机采用的是激光等离子体 EUV 光源。其原理是通过高强度激光与靶材的相互作用,使靶材吸收高能,而被加热气化并产生高温等离子体,从而产生 13.5nm 的 EUV 光源,ASML 公司商用化的 EUV 光刻机光源采用了双脉冲激发方案,分别对锡滴进行成形和电离。
首先,1 微米波长的皮秒预脉冲激光精准轰击迅速通过的直径约为 27 微米的锡液滴,使液滴膨胀, 扩散成高密度的圆顶状分布;紧接着,重复频率 50kHz、直径为几百微米的主脉冲二氧化碳(CO2)激光器光斑再次精准轰击膨胀后的锡液滴,通过 CO2 激光器激发等离子体物理机制产生 EUV 光。
七、EUV 光刻机光源的双脉冲激发方案
为获得高亮度的 6.Xnm 波长光源,目前使用波长为 1030nm 的 Yb:YAG 脉冲激光设备照射钆(Gd)靶材产生等离子体,研究结果表明,Gd 等离子体的 BEUV 转换效率仅为 0.47%。
目前实际 EUV 光刻机中的 EUV 转换效率约为 5% 左右。简而言之,BEUV 光刻机中的 BEUV 转换效率比 EUV 光刻机中的 EUV 转换效率低将近一个数量级!当前一台 EUV 光刻机每天的耗电量为 3 万度,而 BEUV 光刻机则可能达到 30 万度。
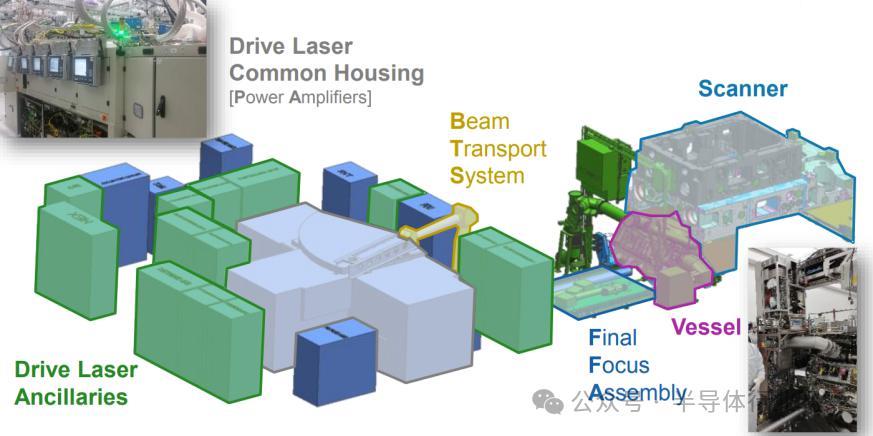
EUV 光刻机光源
当然,基于钆(Gd)、铽(Tb)、铝(Al)、镁(Mg)和镁 - 铜 - 钆合金(Mg65-Cu25-Gd10)等靶材激光等离子体的 6.Xnm 光源还在研发中,BEUV 转换效率应该还有提升的空间。
6.Xnm 多层膜的设计与传统的 EUV 多层膜设计类似,均起源于薄膜干涉理论。但是,当前已经商业化 13.5nm 波段的 Mo/Si 多层膜的反射率最高可以达到 69.5%,寿命为 30000 小时。理论上,La/B 是优秀的 6.Xnm 多层膜系结构,其理论反射率能达到 78% 以上。
但是实际上,6.Xnm 多层膜的反射率研究结果却令人大跌眼镜,不足 60%。这将大大增加了投影光学中掩模和反射镜的热量,加速 6.Xnm 多层膜反射镜的老化和性能衰减。
EUV 光刻胶面临的一个关键问题是随机效应。EUV 光刻胶的 EUV 光子吸收和二次电子散射本质上都是随机事件。随机效应会导致缺陷,包括特征尺寸不均匀和边缘粗糙,甚至接触缺失、桥联等严重缺陷。BEUV 光刻胶面临的随机效应更为严重,主要原因是更短波长下的光子吸收噪声水平将明显上升。
八、几点关于 BEUV 光刻机技术的看法
以下是作者几点关于 BEUV 光刻机技术的看法,需要特别指出的是,这些观点仅代表作者本人的。
1. 艾里、阿贝和瑞利的研究成果导致了瑞利判据的产生。瑞利判据广泛应用于显微镜、望远镜、摄影、光刻机等光学设备。为人们提供了一个判断物体细节是否可以被光学设备分辨的标准。
2. 进入 21 世纪,公开发表的 " 突破瑞利判据 " 的理论与实验学术论文数以万计,成就了诸多的 " 全球高被引科学家 "。多种超分辨成像技术打破了衍射极限的限制,突破了瑞利判据,带来了一场新的显微成像技术革命。
3. 这些 " 突破瑞利判据 " 的显微成像技术尚未实现大规模商业化。遵循瑞利判据的传统显微镜(分辨率约 200nm)仍然广泛应用于科研、工业生产、医疗、教育等众多领域,其市场规模逼近 100 亿美元,而且呈现出快速发展的趋势,市场规模不断扩大。
4. 近 60 年来,瑞利判据一直是光刻机发展的基础,一直被光刻产业界奉为 " 金科玉律 "。光刻机的波长已经经历了从 435nm 到目前的 13.5nm 的五代跨越,EUV 光刻机的数值孔径 NA 也从 0.33 提高到 0.55,其极限分辨率达到 8nm。
5. 但是,高 NA EUV 光刻机的发展仍然面临诸多挑战,除了高达 3.5 亿欧元的售价外,技术层面仍然有诸多令人难以接受的缺点,尤其是最大曝光场尺寸仅为 26 毫米 ×16.5 毫米,这对大面积芯片及产率影响较大,使光刻 " 面积墙 " 问题更为突出。
6. 瑞利判据限制是光刻技术发展的原理性障碍,是一片笼罩在光刻技术研究者头顶的阴霾。为此,多种超分辨光刻技术正在研究之中,但是商业化前景尚不明朗。纳米压印技术初步展现了在 3D NAND 领域的应用前景,但是在逻辑芯片中的应用前景尚不乐观。
7. 根据瑞利判据,波长为 6.X nm 的 BEUV 光刻机是 2037 年后延续摩尔定律的重要选择之一。同等分辨率下, BEUV 光刻机比 EUV 光刻机具有更大的焦深,带来更大的工艺容忍度。
8. BEUV 光刻机在技术上远未成熟,包括更高 BEUV 转换效率的 6.Xnm 光源、更高反射率和更长寿命的 6.Xnm 多层膜,还有减轻随机效应的 6.Xnm 光刻胶。
9. 尽管 BEUV 光刻机的技术未成熟,但是能否商业化,与其说取决于技术上的突破,不如说取决于摩尔定律延续的必要性。其原因是逻辑芯片通过堆叠方式进行性能扩展的研究进展也在不断取得进步。
10. BEUV 光刻机充分继承了前期 EUV 光刻机的研究成果,毫无疑问,作为目前唯一能量产 EUV 光刻机的公司,ASML 公司在 BEUV 光刻机研发中占据了极具优势的位置。

用户对喜马拉雅的“一台设备一充值”的抱怨引发了网友的吐槽,认为这是一种花式割韭菜行为。
科技热搜 喜马拉雅 天猫精灵 手表 设备 韭菜 新闻 资讯 直播 视频 美图 社区 本地 热点 2023-08-07

“遥遥领先”,一个华为热梗的走红
科技热搜 华为 芯片 余承东 华为mate 雷蒙 新闻 资讯 直播 视频 美图 社区 本地 热点 2023-09-29

华为 Mate 60 Pro DXOMARK 影像测试结果出炉:总分157,位列排行榜第 1 名
科技热搜 华为mate google pixel oppo find x iphone 新闻 资讯 直播 视频 美图 社区 本地 热点 2023-11-17

《繁花》:A先生最后一集终于露脸,为何是宝总的模样?
娱乐热点 导演 a股 李产 股市 陈真 新闻 资讯 直播 视频 美图 社区 本地 热点 2024-01-18

韩国女团大尺度造型惹争议,穿着令人费解,成员还有中国人
娱乐热点 造型 韩国 尺度 中国人 穿着 新闻 资讯 直播 视频 美图 社区 本地 热点 2024-02-04
 曾被卖出19万美元高价!这台初代iPhone太猛了
曾被卖出19万美元高价!这台初代iPhone太猛了
热门赛事

苹果首次允许欧盟用户从网站安装应用/雷军称对汽车价格战做好准备/微博上线热搜投诉入口
科技热搜 2024-03-13

在游戏里搞政治正确的幕后黑手,快被外国网友冲烂了。
科技热搜 2024-03-13
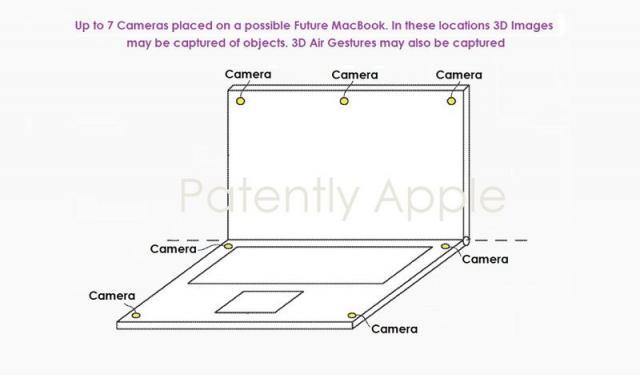
苹果 MacBook 新专利获批:可录制3D 图像/视频、追踪空中手势
科技热搜 2024-03-13

芯片代工营收排行榜公布:台积电独占六成,狂揽近200亿美元
科技热搜 2024-03-13

手机进水放米缸?苹果说这招没用。
科技热搜 2024-03-13

TikTok以“美式”反击“美式”
科技热搜 2024-03-13

消息称暴雪国服回归将在一个月内官宣,网易雷火营销/互娱运营
科技热搜 2024-03-13

从“放生”农夫山泉开始,这事算是彻底成互联网闹剧了。
科技热搜 2024-03-13
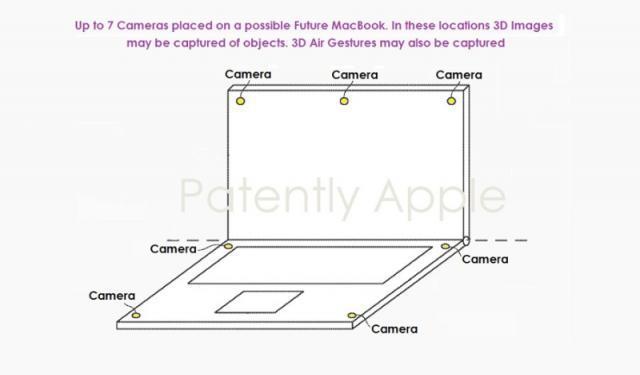
苹果获得适用于折叠设备和MacBook的摄像头系统专利
科技热搜 2024-03-13

消息称现代汽车将研发5纳米车用半导体,有望由三星、台积电代工
科技热搜 2024-03-13